本文为本人模电课程学习笔记,如有错误敬请指正
半导体二极管原理
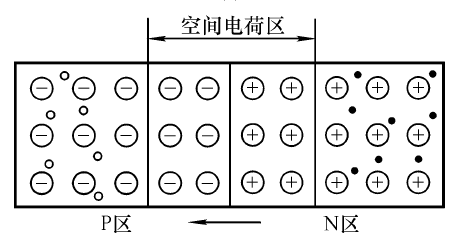
特性
对温度、光照反应灵敏 : 温度和光照改变了电子的活泼程序,从而影响本征激发的离子浓度,改变半导体的物理性质
受杂质影响显着 : 由于本征激发粒子少,又因为杂质容易电离,故载流子浓度和性质明显受杂质影响。
结构
本征半导体:
描述:由纯净晶体结构组成的半导体。常用四价元素,特点是它们刚好形成四个共价键构成穏定结构。
性质:本征激发,本征激发的原理为电子获能突破共价键束缚,激发出带负电的自由电子和带正电的空穴,它们同时作为载流子移动而在半导体中产生电流。半径激发时电离出的离子浓度称为本征浓度。

杂质半导体
描述:
为了实现特定目的,有控制地掺入杂质改变载流子浓度,从而改变了导电能力的半导体。由于掺入杂质近乎全部电离,产生的载流子浓度远大于本征激发浓度,因此半导体特性主要视乎其掺入的杂质。主要分为掺入了V族元素的N型半导体,以及掺入III族元素的P型半导体。
N型半导体:
通过在本征半导体中掺入V族元素,V族元素与IV族元素形成共价键后产生多途的电离电子,使半导体中的自由电子变为多数载流子(多子),空穴变为少数载流子(少子)。该结构所产生的半导体称为N型半导体。
P型半导体:
通过在本征半导体中掺入III族元素,III族元素与IV族元素形成共价键后产生缺失电子的空穴,半导体中的空穴变为变为多数载流子(多子),电子变为少数载流子(少子)。所产生的半导体称为P型半导体。
P-N结
结构
P-N结,通过工艺使半导体一侧形成P型半导体,一侧形成N型半导体,可使二者交界处形成P-N结。
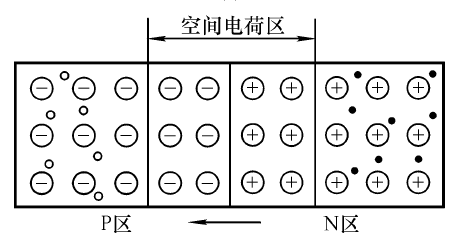
特点
P-N结半导体中同时存在俩种载流子运动形成的电流。
一种是由于载流子浓度差而随浓度梯度扩散的扩散电流,俩种载流子在PN交界处相复合抵消使得交界处的带四个共价键的杂质离子呈现电性,此时在交界处非电中性而存在由扩散作用导致的电场被称为内电场,内电场的建立导致粒子扩散需要克服电场力做功,提升了粒子扩散所需的势能,从而阻止了粒子的扩散运动。
另一种则是载流力受电场力作用下的漂移电流,由于PN俩极交界处形成了带电性的空间电荷区,空间电荷区的内电场促使对应载流子(少子)按电场方向移动形成漂移电流。由于其方向与扩散电流相反。
附注一:对扩散运动和漂移运动可分别通过扩散系数和迁移率进行量化描述,需注意其数值随温度进行变化。
附注二:扩散电流是多子流向低浓度区域,漂移电流是少子流向高浓度区域。实际上考察其中一种载流子时,在二者作用下粒子转移趋向平衡。
结构原理
扩散运动导致了非电中性的空间电荷区,从而导致了漂移运动的出现。则当扩散运动与漂移运动达到平衡时,通过交界面的电荷数动态为零。从而使得P-N结形成缺少载流子的高阻区(又称耗尽层)。由于空间电荷区无载流子,故P-N结两侧的粒子存在电势差,因此空间电荷区又被称为势垒区。
附注一:由分析可得,N区的电位较P区高,其差值可通过求出,其中为接触电位,为受主和施主杂质浓度,为本征载流子浓度。附注二:P-N结穏定有具有一定宽度,其大小与材料及掺杂浓度相关。
性质
单向导电性:
正向导电:P-N结正向偏置,即回路内连接P极至正极(高电势),同时连接N极至负极(低电势)时,外加电场方向与内电场相反(可认为除P-N结外的部份都呈电中性,即可近似为导体而保持等势,因此电场主要施加在P-N结上),由此外电场减弱了内电场的作用,使得扩散作用大于漂移作用,总体上形成扩散电流(破坏了俩种运动的平衡,使载流子进入到空间电荷区。),由此P-N结能在很小的电压变化上引起很大的电流变化,此时P-N结呈低电阻状态。
反向截止:P-N结反向偏置,即回路内连接P极至负极(低电势)同时连接N极至正极(高电势)时,外加电场方向与内电场相同,增加的电场减弱空间电荷区上的扩散作用并加大了漂移作用,总体上形成漂移电流,但由于漂移电流的载流子(少子)的浓度低,流过的电流十分微弱,因此外电场增加时电流依然十分微弱,并很快达到饱和状态(增加外电场不再导致电流增加),由于称该电流为反向饱和电流。此时P-N结呈高电阻状态。
伏安特性:
描述任一电氣元件時,我們最关心的往往是其电氣特性。而二极管的伏安特性可以通过直接测量並进行数据拟合得到,其表达式為一个指数形式的表达式,可通过查閱模电相关參考書可得到該表达式的更多細節。具体為
其中为反向饱和电流,为温度电压当量,室温取26mV。

击穿特性:
雪崩击穿:反向偏置低掺杂的P-N结时,当外加电压超过某一数值(硅:),少子的动能增加并碰价电子对产生动能较高的空穴对,此时新产生的空穴对经过电场加速后撞击其他价电子对,产生连锁反应,从而使P-N结内的载流子急剧增加,总体上表现为电流剧增。(但电压变化很小,常被用作穏压管)
齐纳击穿:反向偏置高掺杂的P-N结时,其击穿电压较雪崩击穿低(硅:),原因是高掺杂导致其势垒区宽度低,使得外电场较小时便可在势垒区产生较大的迭加场强,使足够价电子脱离共价键,从而使电流增大。
附注一:雪崩击穿具有正温度系数,即当元件温度升高时,只有施加更大的电压才能导致雪崩击穿,这是由于晶格在温度高时振动更强烈,使得载流子与晶格碰撞导致的能量损失增加,从而需提供更多能量引发连锁反应。
附注二:齐纳击穿有负的温度系数,原因是齐纳击穿基于隧道效应,由于隧道间距与禁带寛度成正比,与场强成反比,又因禁带寛度与温度负相关,因此在高温下隧穿的载流子随温度增加,从而能在较低的电压下引发击穿。参考:为什么齐纳击穿是负温度系数-知乎

电容特性:
外电场发生改变时,空间电荷区内储存的电荷量发生变化,满足关系,则称其存在电容特性。
势垒电容:在P-N结反偏时改变反偏电压,则空间电荷区的寛度随之变化,使得空间电荷区储存电荷量变化,其过程满足电容物理模型,则可把这种变化等效为电容,称为势垒电容。
扩散电容:P-N结正偏时,戴流子从高浓度向低浓度区域扩散,在空间电荷区和边界层形成浓度梯度。且边界层上的非平衡少子梯度浓度随正偏电压改变,从而导致了边界层上储存的电荷量改变。其变化满足电容模型,称为扩散电容。
附注:可视作非线性电容,当高频正偏时扩散电容不可忽略,高频反偏时势垒电容不可忽略。